
微波等离子体芯片开封设备
关键词:标准漏孔 | MPCVD | 电容薄膜规真空计 | 高低真空校准装置 | 氦漏孔校准装置
分类:
产品详情
芯片解封也称开封、开盖和开帽,开封过程中主要是去除互连结构中的下填料(主要成份为环氧树脂),使引线键合或芯片本身完整裸露出来。环氧树脂材料封装芯片示意图如图3所示,开封过程要对完整封装的IC做局部腐蚀使其暴露,同时保持芯片功能的完整无损,保持 die, bond pads, bond wires乃至lead-不受损伤, 以及Au、Cu或Ag引线不受损伤。
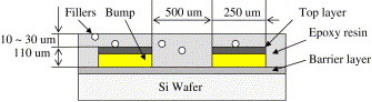
图3 环氧树脂材料封装芯片示意图
微波等离子法开发了适用于各类半导体器件的微波等离子体刻蚀专用装备,如图4所示。微波等离子体刻蚀设备具有能量密度高、刻蚀效果好、刻蚀速率快、可通入各类保护气体等优点,适用于环氧树脂和硅基混合材料的快速刻蚀开封,同时在纯O环境下可对Au和Cu引线进行有效保护,通入H2可对Ag引线进行有效保护,满足各类不同金属引线芯片的高效率刻蚀。
等离子开封
开封过程不造成损伤保留表面特征
保留原始污染杂质和失效点
化学开封
会减小导线直径会减小机械强度
会腐蚀铜线和铝质焊盘
等离子开封
只使用氢氧配方,对芯片损伤小减少80%开封时间
全自动开封过程
保留原始污染杂质和失效点常规气压,减少维修和维护成本
传统等离子开封
CF4刻蚀对钝化层和芯片会造成损伤
虽然添加CF4,但开封时间依然较长
需手动清洗每个蚀刻步骤所产生的无机杂质
可能导致原始污染杂质和失效点会被消除
真空系统,维修和维护成本较高

图4 微波等离子体刻蚀设备
采用微波等离子刻蚀设备对环氧树脂硅混合材料封装芯片进行刻蚀开封,未开封前芯片表面形貌如图5(激光开封过后)所示,可见芯片键合Cu引线已被封装材料涂覆,采用纯O低压环境对封装芯片进行刻蚀,刻蚀开封后的芯片形貌如图6所示,芯片表面的环氧树脂封装材料已全部被微波等离子体刻蚀,且键合材料Cu引线未被损伤,刻蚀后可见芯片表面清晰结构。因此,微波等离子体刻蚀适用于半导体芯片的高效、稳定、无损开封。
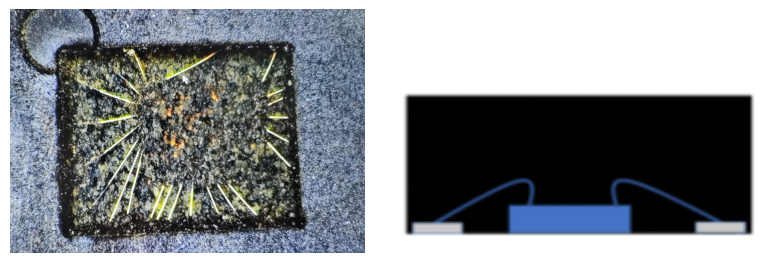
图5 未开封芯片表面形貌及其截面示意图
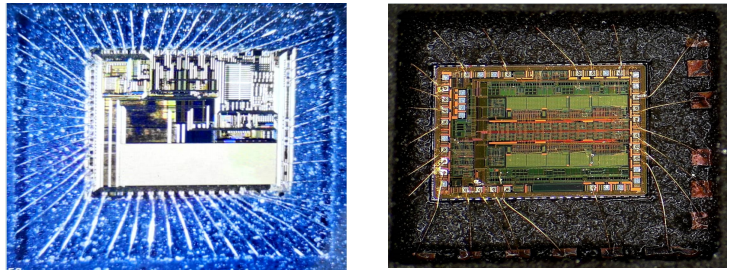
图6 微波等离子体刻蚀开封后芯片表面形貌及其截面示意图
失效分析和质量控制的应用
1、 键合线(Wire bond):
⚫ 银线(Ag)
⚫ 铜线、复合型胶凝材料、金线、 铝线(Cu,PCC,Au,Al)
⚫ 常规或经过老化测试的样品
2、 倒装芯片(Flip Chip)
⚫ 重布线层(RDL)
⚫ 铜柱(Cu Pillar)、焊锡凸块(Solder Bump)
⚫ 扇入型和扇出型 WLP
3、 芯片
⚫ BOAC
⚫ SAW、BAW
⚫ 砷 化 镓 芯 片 、 氮 化 镓 芯 片 GaAs,GaN
4、 封装
⚫ 2.5D / 3D
⚫ SiP、CoWoS
⚫ Chip on Board
5、 封装材料
⚫ High Tg
⚫ Glob Top
⚫ Underfill、DAF、FOW
⚫ Clear Mold, Die Coat
6、 FA 类型
⚫ 电气过应力(EOS)
⚫ 迁移(Migration)
⚫ 腐蚀(Corrosion)
⚫ 杂质污染(Contamination)
相关产品
产品询价
